作者:原创
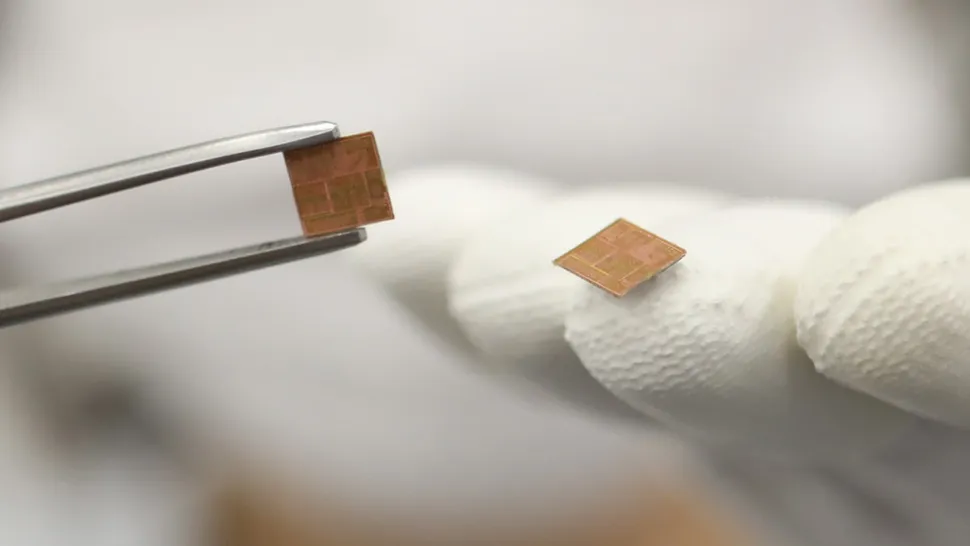
智能手机制造商正在竭尽全力寻找让设备更紧凑或安装更大电池的方法。LG Innotek宣布,在世界上首次开发出了适用于移动用高附加值半导体基板的“ Cu-Post(铜柱)技术”,并成功将其应用于产品的批量生产。通过使用新的铜柱来替代连接芯片基板和主板的焊球,将进一步减薄智能手机的内部结构。
LG Innotek开发的这种新封装方法是在基板上先放置铜柱,然后再在其上方放置焊球,而不是像传统方式那样直接将焊球粘附在表面。与传统布局相比,这种结构将焊球之间的间距减少了大约20%,同时保持了相同的电气性能。LG声称,这种新方法为智能手机设计人员提供了更大的灵活性,以便进一步减薄设备并为电池等特性腾出更多空间。
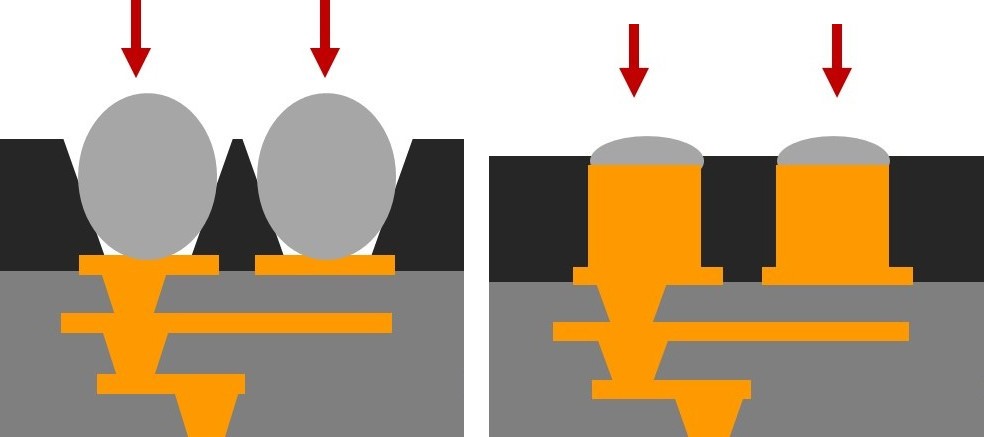
除了尺寸减小外,铜柱还能实现更密集的封装,并且非常适合高性能接口,这有助于提升智能手机的功能和性能。
铜的高熔点确保了在高温制造步骤中,铜柱能够保持其形状,从而实现了更紧密的集成。此外,铜的导热性比典型焊接材料高出七倍以上,能够更快地散发半导体封装中的多余热量。这有助于保持稳定的性能,并最大限度地减少因过热导致的信号退化等问题。
LG Innotek自2021年开始研发铜柱技术,并应用基于数字孪生的3D模拟技术来加速开发并提高设计精度。到目前为止,LG Innotek已经获得了大约40项与铜柱技术相关的专利。现在,该公司计划将这项技术应用于智能手机和可穿戴设备的RF-SiP基板(即调制解调器、功率放大器、FRM、滤波器集成到一个封装中)和FC-CSP(应用处理器的倒装芯片芯片尺寸封装)基板。
 奇谱科技
奇谱科技